先进制程晶圆级FIB制样及TEM分析
先进制程晶圆级FIB制样及TEM分析服务通过对纳米材料指定位置进行FIB制样, 结合透射电子显微镜(TEM)技术,为先进制程芯片提供精准的样品制备与结构分析解决方案。
评价
服务内容
先进制程芯片分析
服务范围
针对芯片制造及设计企业7nm及以下先进制程芯片,对其金属层、M0层、FinFET等结构进行全面解析,用于验证先进制程工艺的稳定性和关键工艺节点,还可用于同类竞品分析、逆向分析等
服务背景
随着集成电路制造工艺不断提升,代表芯片制程关键节点的数字越来越小,比如从65nm,40nm芯片制程,到22nm,14nm,7nm,4nm,3nm制程。节点数字越小意味着更先进的制程,即晶体管理集成度越好、处理速度越快、功耗越低;同时也意味着芯片内部结构的复杂性增加,关键结构尺寸减小,逐步发展成一般的显微成像技术(比如光学显微镜)无法观测的纳米级尺寸。
由于TEM样品需非常薄,电子才可穿透,形成衍射图像。FIB的高效溅射可实现对样品的精细加工,因此FIB常用于TEM超薄样品的制备优化上。
我们的优势
广电计量具备消除FIB聚焦离子束窗帘效应的方法、新型框架结构法DB FIB制备热敏感型TEM超薄样品、FIB阶梯减薄法制备脆性易裂材料的超薄TEM样品、不耐辐照精细结构晶圆样品的聚焦离子束超薄切片制样预处理方法、FIB倒切制备TEM样品的方法等专利技术,获得了高质量、无电子束损伤的TEM高分辨图像,实现了对先进制程芯片原子级分辨率的形貌表征和成分分析。
案例分享
芯片FA分析-3D TEM法
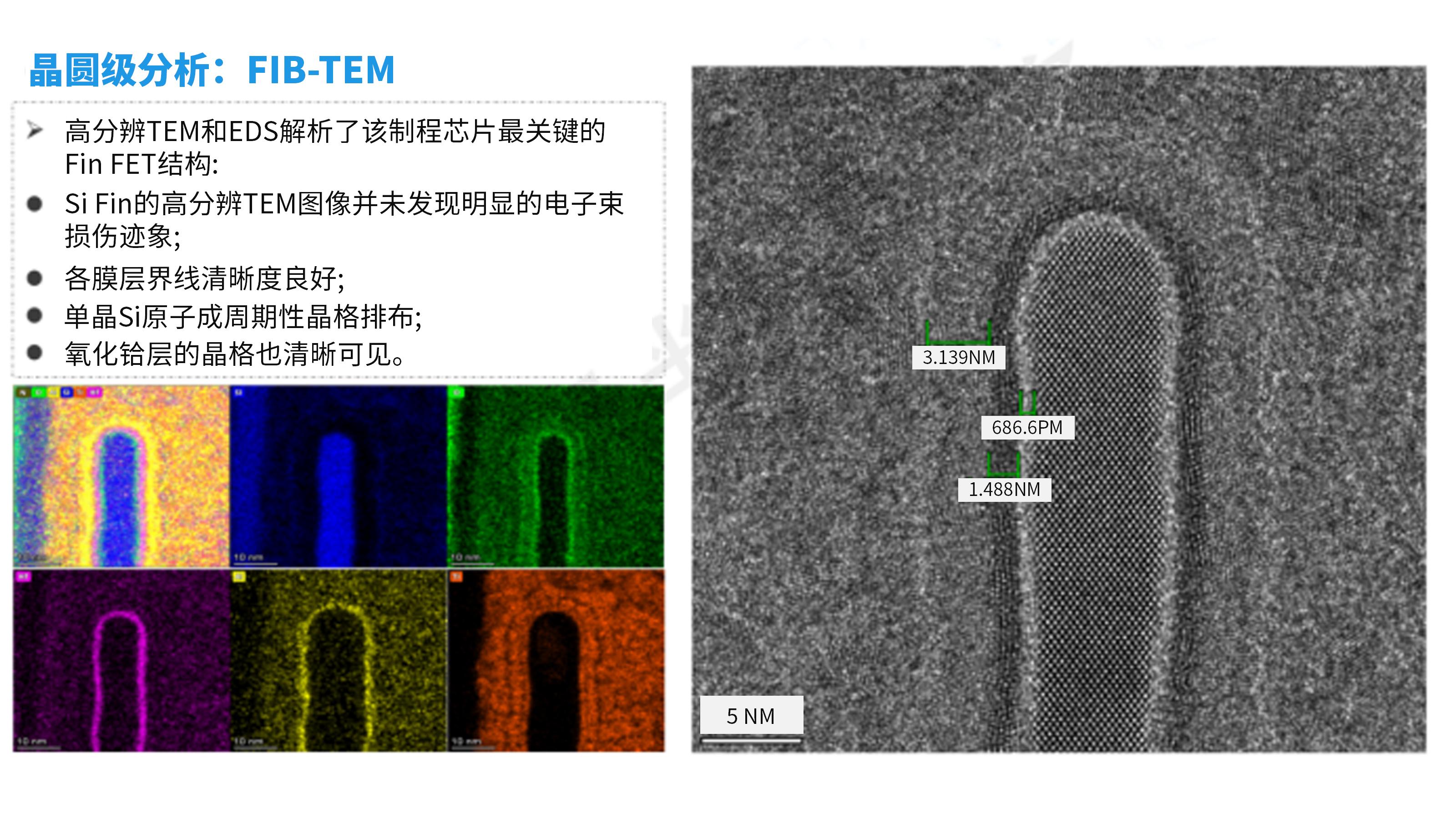
业务咨询
